
昂筠國際相關影片

-
- 超薄軟性銅箔基板(2L-FCCL)
- 昂筠超薄載板銅箔(附載體可撕型超薄銅箔)
- 卷對卷真空磁控濺鍍金屬薄膜代工
- 石墨銅箔散熱膜 (DLC類鑽碳銅箔複合材料)
- IC封裝散熱片, 金屬條狀散熱片
- R2R鍍鎳薄膜(Nickel Coated Film)
-
昂筠超薄載板銅箔 (附載體可撕型超薄銅箔)
產品介紹:
附載體超薄銅箔主要用於採用MSAP製程形成線路的Prepreg載板及Coreless基板。昂筠超薄載板銅箔是採用18um載體銅箔與可撕型超薄銅箔所組成。一般來說,客戶會將載板銅與膠片層壓後剝除18um載體銅箔,只留下可撕型超薄銅在載板中作為銅種子層(Seed Layer)來製作極細線路使用。
IC封裝與PCB製程產業的產品為了配合終端電子設備朝向輕薄短小的目標,在材料選擇上會傾向輕薄化、高可靠度,而電路設計上則會傾向細線路、高密度化。而達到這些目標的關鍵之一就是超薄銅箔,因為封裝載板為了要做15~20um的極細線路,必須用到3um超薄銅皮的薄基板,取代目前常用的銅箔厚度18~35μm。
IC載板是用於封裝IC晶片的載體,其厚度和重量直接影響IC封裝產品的輕薄化。隨著IC元件功能趨向複雜化,使用的板層數也跟著增加,PCB的厚度和重量也隨之增加。為了滿足終端電子產品輕薄化的需求,超薄銅箔將成為PCB製造的趨勢。除了增層膠片製程外,未來作為核心層的銅箔基板也可能採用超薄銅箔來滿足設備薄型化的趨勢。
IC載板用超薄銅箔的厚度一般在2um到5um之間,昂筠超薄載板銅箔產品以3um/5um產品為主。

■ 昂筠超薄載板銅箔為附有18um載體銅箔的可剝離型極薄銅箔
■ 適用於PCB製程中mSAP改良式半加成法製程,建議線寬/線距(L/S)≦40/40之極細線路基板應用
■ 由18um載體銅箔搭配PVD物理氣相沉積製程來製作金屬分離層+3um/5um水平鍍銅增厚技術所完成的產品
■ 低銅箔粗糙度(Rz≦2.0),以PCB業界profile來分類時,粗糙度近似於HVLP銅箔
■ 適用于IC封裝載板、HDI高密度互連技術板、Coreless 基板、IC封裝制程材料等用途
■ 超薄銅箔適合承載的電流為5安培以下,對電氣負載要求較低,但對精細線路、高頻高速信號以及微小尺寸有高需求的應用領域
■ 本材料經SGS檢驗,符合RoHS、Reach規範綜合來看,Rz<2的超薄銅箔在高速、高頻、小型化電子產品中具有優越性能,且能支持更精細線路製程,是未來先進電子製造的關鍵材料之一。
產品應用:
低粗糙度Rz<2的超薄銅箔(2~5微米)主要應用在高階PCB製造,特別是對高速、高頻訊號及微細線路要求高的產品領域。其潛在應用包括:- 高密度互連(HDI)電路板:超薄銅箔可以實現更細微的線路設計,提高線路密度和性能,適用於手機、通信設備等高端電子產品。
- IC載板與Coreless基板:低粗糙度提供了優良的電氣性能和訊號完整性,適合覆晶晶片封裝和其他高頻高速應用。
- 5G和高速通信設備:超薄且低粗糙度的銅箔減少訊號損失,提升高速訊號傳輸質量,符合高頻低損耗基板需求。
結構組成/Composition

*對產品有興趣,立刻聯絡我們 Email: joe_lin@topnano.com.tw (林先生)
使用方式(僅供參考)
<方式一> 在PCB製程中連同18um承載銅箔與包含PP等各種樹脂基材做壓合,形成CCL,再將18um承載銅箔撕離。
<方式二> 在PCB製程中將昂筠超薄載板銅先經過蝕刻製程做完線路後,再與PP等樹脂基材做壓合,再分開18um承載銅箔。
相關媒體採訪報導 :代表性特性數據/Representive data-昂筠載板銅for MSAP Process昂筠IC載板銅規格
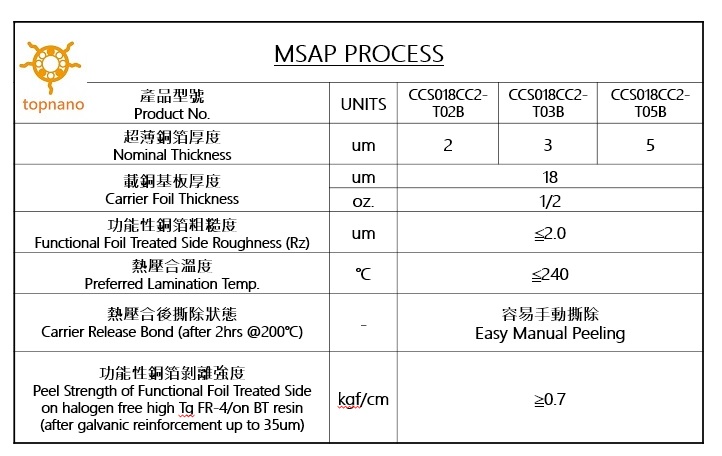
代表性特性數據/Representive data-昂筠載板銅for Coreless Process

※上述表列為代表性數據非保證值
※Peel Strength為增鍍到35um厚度之後的測試值
※目前供貨可選擇2種類型 : 亮面銅箔無粗化版 /霧面銅箔需粗化版
※載體銅箔固定為18um銅箔,可撕型超薄銅部分未來可依客戶所需,客製化製作1.5um~5um超薄銅
更多超薄銅箔及mSAP相關知識:
最佳使用及保存期限:
訂單上所標明的出貨日期起算6個月之內。
