
昂筠国际相关影片

-
- 双层无胶超薄挠性覆铜板(2L-FCCL)
- 昂筠超薄载板铜箔(附载体可撕型超薄铜箔)
- 卷对卷真空磁控溅射金属薄膜代工(PET镀铜膜)
- 石墨铜箔散热膜 (DLC类钻碳铜箔复合材料)
- IC封装散热片, 金属条状散热片
- R2R镀镍薄膜, 铜镍薄膜
-
昂筠超薄载板铜箔 (附载体可撕型超薄铜箔)
产品介绍:附载体超薄铜箔主要用于采用MSAP制程形成线路的Prepreg载板及Coreless基板。昂筠超薄载板铜是采用18um载体铜箔及可撕型超薄铜箔所组成。一般来说,客户会将载板铜与胶片层压后剥除18um载体铜箔,只留下可撕型超薄铜在载板中作为铜种子层(Seed Layer)来使用。
IC封装与PCB制程产业的产品为了配合终端电子设备朝向轻薄短小的目标,在材料选择上会倾向轻薄化、高可靠度,而电路设计上则会倾向细线路、高密度化。而达到这些目标的关键之一就是超薄铜箔,因为封装载板为了要做15~20um的细线路,必须用到3um超薄铜皮的薄基板,取代目前PCB常用的铜箔厚度18~35μm。IC载板是用于封装IC芯片的载体,其厚度和重量直接影响IC封装产品的轻薄化。随着IC组件功能趋向复杂化,使用的板层数也跟着增加,PCB的厚度和重量也随之增加。为了满足终端电子产品轻薄化的需求,超薄铜箔将成为PCB制造的趋势。除了增层胶片制程外,未来作为核心层的铜箔基板也可能采用超薄铜箔来满足设备薄型化的趋势。IC载板用超薄铜箔的厚度一般在2um到5um之间,初期昂筠超薄载板铜产品会以3um/5um产品为主做推广使用。

■ 昂筠超薄载板铜为附有18um载体铜箔的可剥离型极薄铜箔
■ 适用于PCB制程中mSAP半加成法制程,建议线宽/线距(L/S)≦40/40之细线路IC基板应用
■ 由18um载体铜箔搭配PVD物理气象沉积制程制作金属分离层+3um/5um水平镀铜增厚制程所完成的产品
■ 低铜箔粗糙度(Rz≦2.0),以PCB业界profile轮廓来分类时,粗糙度近似于HVLP铜箔(高频超低轮廓铜箔)
■ 适用于IC封装载板、HDI高密度互连技术板、IC封装制程材料等用途
■ 超薄铜箔适合承载的电流为5安培以下,对电气负载要求较低,但对精细线路、高频高速信号以及微小尺寸有高需求的应用领域
■ 本材料经SGS检验,符合RoHS、Reach规范
应用:
低粗糙度Rz<2的超薄铜箔(2~5微米)主要应用在高阶PCB制造,特别是对高速、高频讯号及微细线路要求高的产品领域。其潜在应用包括:- 高密度互连(HDI)电路板:超薄铜箔可以实现更细微的线路设计,提高线路密度和性能,适用于手机、通信设备等高端电子产品。
- IC载板与Coreless基板:低粗糙度提供了优良的电气性能和讯号完整性,适合覆晶芯片封装和其他高频高速应用。
- 5G和高速通信设备:超薄且低粗糙度的铜箔减少讯号损失,提升高速讯号传输质量,符合高频低损耗基板需求。
*对产品有兴趣,立刻联络我们 Email:joe_lin@topnano.com.tw (林先生)*
使用方式(仅供参考)
<方式一> 在PCB制程中连同18um承载铜箔与包含PP等各种树脂基材做压合,形成CCL,再将18um承载铜箔撕离。
<方式二> 在PCB制程中将昂筠超薄载板铜先经过蚀刻制程做完线路后,再与PP等树脂基材做压合,再分开18um承载铜箔。
结构组成/Composition

代表性特性數據/Representive data-昂筠载板铜for Coreless Process昂筠IC载板銅規格

代表性特性數據/Representive data-昂筠载板铜for MSAP Process
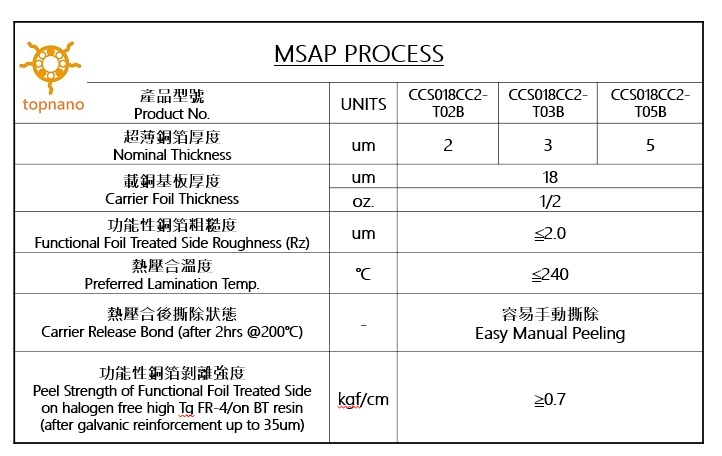
※上述表列为代表性数据非保证值
※Peel Strength为增镀到35um厚度之后的测试值
※目前供货可选择2种类型 : 亮面铜箔无粗化版 /雾面铜箔需粗化版
※载体铜箔固定为18um铜箔,可撕型超薄铜部分未来可依客户所需,客制化制作1.5um~5um超薄铜
更多超薄铜箔及mSAP相关知识:
产品最佳使用期及保存期:
订单上所标明的出货日期起算6个月之内。
